麻省理工学院 | 麻省理工学院公布基于CMOS的三维毫米波GaN技术
可扩展技术能够在标准硅芯片上集成高速GaN晶体管 麻省理工学院等机构的研究人员开发出一种新的制造工艺,能以低成本、可扩展、兼容现有半导体代工厂的方式将高性能GaN晶体管集成到硅CMOS芯片上。 这项研究以“3D-Millimeter Wave Integrated Circuit (3D-mmWIC): A Gold-Free 3D-Integration Platform for Scaled RF GaN-on-Si Dielets with Intel 16 Si CMOS”为题,于近期在旧金山举行的IEEE射频集成电路研讨会(6月15日至17日)上发表。 该方法涉及在GaN芯片表面构建许多微小晶体管,然后切割出每个晶体管,接着使用低温工艺将必要数量的晶体管与硅芯片接合,从而保留两种材料的功能。 研究团队表示,只在芯片中加入了极少量的GaN材料,因此成本仍然很低,但由此产生的设备却能通过紧凑型高速晶体管获得显著的性能提升。此外,通过将GaN电路分离成可分布在硅芯片上的分立晶体管,新技术还能降低整个系统的温度。 研究人员利用该工艺制造了一种功率放大器,与采用硅晶体管的功率放大器相比,它具有更高的信号强度和效率。在智能手机中,这可以提升通话质量、提高无线带宽、增强连接性并延长电池寿命。 麻省理工学院研究生、该论文的主要作者Pradyot Yadav表示:“我们结合了硅的优势与最佳的GaN电子技术。这些混合芯片可以彻底变革许多商业市场。” 这种新型芯片是多步骤工艺的结果。首先,在GaN晶圆的整个表面制造紧密排列的晶体管。利用非常精细的激光技术,将每个晶体管切割成仅有晶体管大小的尺寸(240 x 410 微米),形成研究人员所说的小芯片(dielet)。 每个晶体管顶部都有微小的铜柱,可直接与标准硅CMOS芯片表面的铜柱键合。铜与铜之间的键合可以在低于400摄氏度的温度下进行,温度低到足以避免任何一种材料的损伤。 现有的GaN集成技术需要使用金进行键合,而金是一种昂贵的材料,而且与铜相比,金需要更高的温度和更强的键合力。金会污染大多数半导体代工厂使用的工具,因此通常需要专门的设施。 Pradyot Yadav表示:“我们需要的是一种成本低、温度低、键合力弱的工艺,而铜在这些方面都优于金。同时,铜还具有更好的导电性。” 为实现此集成工艺,研究人员创造了一种专门的新工具,能够将极其微小的GaN晶体管与硅芯片小心地集成在一起。该工具利用真空来固定小芯片,使其在硅芯片上方移动,从而以纳米级精度校正铜键合界面。 使用先进显微镜技术来监控界面,然后当小芯片处于正确位置时,施加热量与压力使GaN晶体管与芯片接合。 Pradyot Yadav表示:“对于流程中的每个步骤,我都必须找到新的合作者,他们知道如何完成我需要的技术,我可以向他们学习,再将技术整合到我的平台中。这是两年的持续学习。”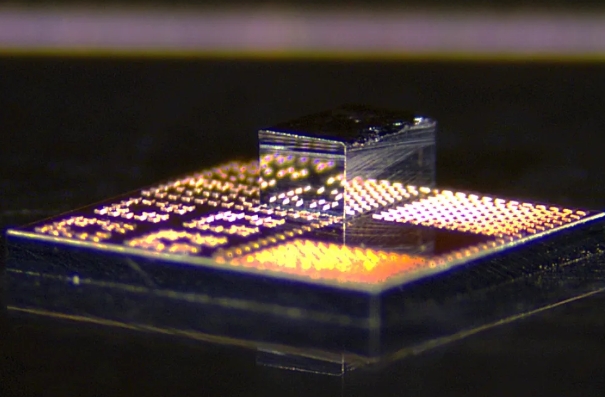
推荐
-

-

QQ空间
-

新浪微博
-

人人网
-

豆瓣




